제조기술
PCB 생산전문기업공정도
01
재단
제품 사양에 따라 원자재를 사내 작업 치수로 절단하는 공정
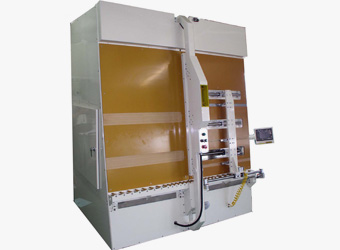
02
내층회로형성
원자재 표면에 드라이 필름을 열과 압력으로 밀착 후 필름과 DATA를 이용하여 빛을 조사한 후 현상을 거쳐 회로를 형성.
회로 형성 후 AOI 검사를 진행하여 제품의 미세한 결함이나 불량 부분을 자동으로 검사.

03
적층
회로가 만들어진 내층기판, Prepreg와 외층이 가공될 동박을 설계사양에 맞게 정합을 유지하도록 쌓아올리는 작업

04
드릴
고객의 HOLE 정보를 기초로 사내에서 편집한 X-Y Coordinates를 이용하여 CNC 방식으로 Working Panel상에 구멍을 가공하는 공정
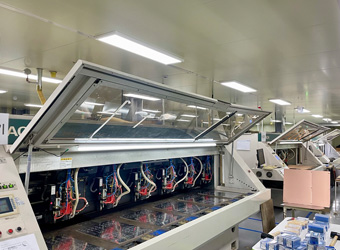
05
동도금
홀 속 벽면은 전도성이 없는 상태로 전기적으로 접속이 가능하도록 전도성이 있는 물질(동)으로 도금하는 공정

06
외층회로(LDI)
원자재 표면에 드라이필름을 열과 압력으로 밀착 후 필름&DATA을 이용하여 빛을 조사한 후 현상을 거쳐 회로를 형성한다.
회로 형성 후 고해상도 카메라를 이용한 AOI 검사를 진행하여 제품의 미세한 결함이나 불량 부분을 자동으로 검사한다.
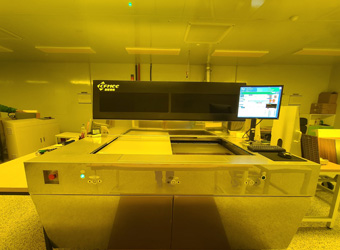
07
PSR
물리 화학적 환경 하에서 내구성을 갖는 불변성 화합물인 불변성 잉크를 도금된 동박 회로 상에 코팅함으로써, 회로를 보호하고 회로와 회로 사이에 SOLDER BRIDGE 현상이 발생하는 것을 방지하기 위해 실시하는 공정.
(PSR정면 – PSR 인쇄 – PSR 노광 - PSR 현상)
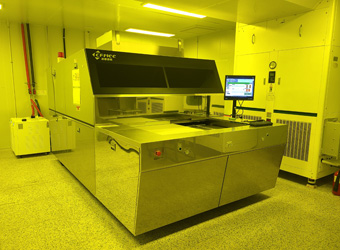
08
표면처리
기판 표면의 산화 및 오염 방지와 부품 실장을 강화하기 위한 공정으로 OSP, HASL, 금도금 등이 있다.
- OSP : Through Hole, Land 등의 동에만 방처제를 화학 반응 시켜 0.2-0.5 미크론 정도의 얇고 균일한 보호피막 형성하는 공정
- HASL : 고온의 땜납 용융 TANK 기판을 침적한 후, 고온, 고압의 열풍으로 불어줌으로써, Solder Mask가 코팅되지 않은 부위에 균일한 두께로 땜납을 입혀주는 공정
- 금도금 : 전기적 석출 방법으로 니켈과 금을 도금해 주는 공정.
전기적 특성이 요구되는 부위에 고객의 요구에 따라 CONTACT FINGER AREA 에만 부분적으로 실시하는 도금.

09
외형가공
생산성 향상을 위해 사용한 WORKING PANEL (작업패널)을 고객이 요구한 최종의 제품 사이즈와 모양으로 만들기 위해 외형 가공하는 공정.
CNC ROUTER M/C과 ROUTER BIT 및 PROGRAM DATA 를 사용하여 작업이 이루어진다.
(금형가공 – 라우팅 – 브이커팅)

10
BBT
Pcb 가공이 완료된 후 회로상의 전기적 결함, open & short, 절연간격 위반 등 기본적인 전기적 성능을 multil-tester로 시험하는 공정.
TEST FIXTURE(JIG)가 별도로 준비되어야 하며, TEST 장비의 종류로는 DEDICATED와 UNIVERSAL이 있다.

11
검사
제작된 PCB의 회로연결 상태 및 외관을 검사하는 공정으로 검사방법은 육안검사와 자동 장비검사로 구분된다.
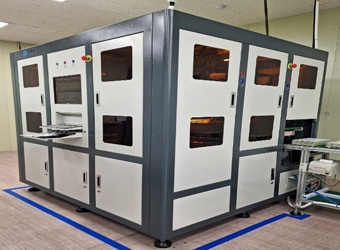
12
포장
고객에게 제품을 납품하기 위해 낱개 및 단위로 포장하는 공정.
진공 포장 후 완충제와 함께 다시 박스 포장을 하며, 고객사 요청에 따라 BOX 라벨 표기, 출하 검사성적서를 첨부하기도 한다.


